
光刻膠由光引��(fā)劑、樹脂、溶劑等基礎組分組成,又被稱為光致抗蝕劑,這是一種對光非常敏感的化合物。此外,光刻膠中還會添加光增感劑、光致產酸劑等成分來達到提高光引��(fā)效率、優(yōu)化線路圖形精密度的目的。在受到紫外光曝光后,它在顯影液中的溶解度會��(fā)生變化��
分類
根據(jù)光刻膠按照如何響應紫外光的特性可以分為兩類��
正膠(Positive Photo Resist��
曝光前對顯影液不可溶,而曝光后變成了可溶的,能得到與掩模板遮光區(qū)相同的圖彀��
��(yōu)點:分辨率高、對比度好��
缺點:粘附性差、抗刻蝕能力差、高成本��
靈敏度:曝光區(qū)域光刻膠完全溶解時所需的能��
負膠(Negative Photo Resist��
與正膠反之��
��(yōu)點: 良好的粘附能力和抗刻蝕能力、感光速度快��
缺點�� 顯影時發(fā)生變形和膨脹,導致其分辨率��
靈敏度:保留曝光區(qū)域光刻膠原始厚度��50%所需的能量��

按感光樹脂的化學結構,光刻膠可分為光聚合型光刻膠、光分解型光刻膠和光交聯(lián)型光刻膠。在應用中,采用不同單體可以形成正、負圖案,并可在光刻過程中改變材料溶解性、抗蝕性等��
光聚合型光刻��
烯類,在光作用下生成自由基,自由基再進一步引��(fā)單體聚合��
光分解型光刻��
疊氮醌類化合物,經光照后,會發(fā)生光分解反應,由油溶性變?yōu)樗苄浴?/p>
光交��(lián)型光刻膠
聚乙烯醇月桂酸酯,在光的作用��,分子中的雙鍵打開,鏈與鏈之間��(fā)生交��(lián),形成一種不溶性的��(wǎng)狀結構從而起到抗蝕作用��
按曝光波長,光刻膠可分為紫外��300~450 nm)光刻膠、深紫外��160~280 nm)光刻膠、極紫外(EUV��13.5 nm)光刻膠、電子束光刻膠、離子束光刻膠、X 射線光刻膠等��
按應用領域,光刻膠可分為PCB 光刻膠、LCD 光刻膠、半導體光刻膠等。PCB 光刻膠技術壁壘相對其他兩類較低,而半導體光刻膠代表著光刻膠技術最先進的水平��
PCB 光刻��
主要分為干膜光刻膠、濕膜光刻膠(又稱為抗蝕��/線路油墨)、光成像阻焊油墨等。PCB 光刻膠技術壁壘相對較低,主要是中低端產品��
LCD 光刻��
包含彩色濾光片用彩色光刻膠及黑色光刻膠、LCD 觸摸屏用光刻膠、TFT-LCD 正性光刻膠等產品��
彩色濾光片是LCD 實現(xiàn)彩色顯示的關鍵器件,占面板成本的14%~16%;在彩色濾光片中,彩色光刻膠和黑色光刻膠是核心材料,占其成本��27%左右,其中黑色光刻膠占彩色濾光片材料成本��6%~8%��
半導體光刻膠
包括g 線光刻膠、i 線光刻膠、KrF 光刻膠、ArF 光刻膠、聚酰亞胺光刻膠、掩膜板光刻膠等��
光刻膠組分及功能
光引��(fā)��
光引��(fā)劑吸收光能(輻射能)后經激��(fā)生成活性中間體,并進一步引��(fā)聚合反應或其他化學反應,是光刻膠的關鍵組分,對光刻膠的感光度、分辨率等起決定性作用��
樹脂
光刻膠的基本骨架,是其中占比最大的組分,主要決定曝光后光刻膠的基本性能,包括硬度、柔韌性、附著力、曝光前后對溶劑溶解度的變化程度、光學性能、耐老化性、耐蝕刻性、熱��(wěn)定性等��
溶劑
溶解各組分,是后��(xù)聚合反應的介質,另外可調節(jié)成膜��
單體
含有可聚合官能團的小分子,也稱之為活性稀釋劑,一般參加光固化反應,可降低光固化體系粘度并調節(jié)光固化材料的各種性能��
光增感劑
是引��(fā)助劑,能吸收光能并轉移給光引��(fā)劑,或本身不吸收光能但協(xié)同參與光化學反應,起到提高引��(fā)效率的作用��
光致產酸��
吸收光能生成酸性物質并使曝光區(qū)域發(fā)生酸解反應,用于化學增幅型光刻膠��
助劑
根據(jù)不同的用途添加的顏料、固化劑、分散劑等調節(jié)性能的添加劑��
主要技術參��(shù)
分辨率(resolution��
是指光刻膠可再現(xiàn)圖形的最小尺寸。一般用關鍵尺寸來(CD,CriticalDimension)衡量分辨率��
對比度(Contrast��
指光刻膠從曝光區(qū)到非曝光區(qū)過渡的陡度��
敏感度(Sensitivity��
光刻膠上產生一個良好的圖形所需一定波長光的最小能量值(或最小曝光量)。單位:毫焦/平方厘mJ/cm2��
粘滯��/黏度 (Viscosity��
衡量光刻膠流動特性的參數(shù)。光刻膠中的溶劑揮發(fā)會使粘滯性增加��
粘附性(Adherence��
是指光刻膠與晶圓之間的粘著強度��
抗蝕性(Anti-etching��
光刻膠黏膜必須保持它的粘附性,并在后續(xù)的濕刻和干刻中保護襯體表面,這種性質被稱為抗蝕性��
表面張力(SurfaceTension��
液體中將表面分子拉向液體主體內的分子間的吸引力��
光刻工藝流程
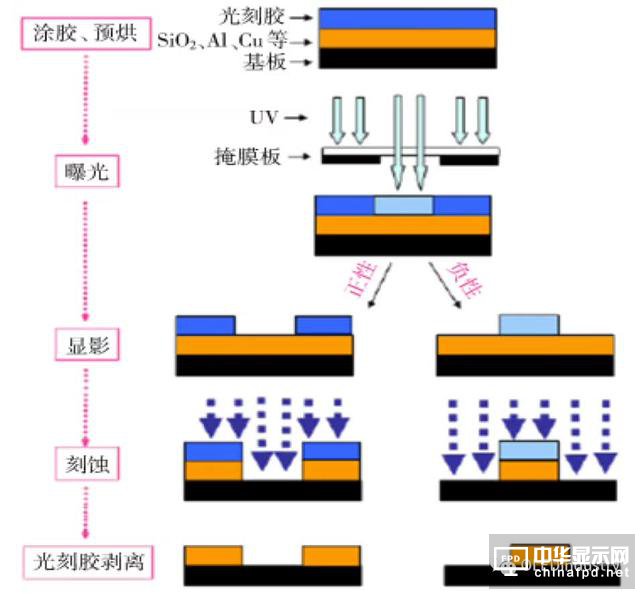
1前處��
微粒清除��
wafer表面的雜質微粒會影響光刻膠的粘附,且會損壞光刻的圖形,造成成品率的下降,所以必須要清潔掉表面的雜質顆粒、表面沾污以及自然氧化層等��
微粒清除方法��
高壓氮氣吹除,化學濕法清洗,旋轉刷刷洗,高壓水噴濺等��
烘干��
經過清潔處理后的晶圓表面會含有一定的水分(親水性表面),所以必須將其表面烘烤干燥(干燥的表面為憎水性表面),以便增加光刻膠和晶圓表面的粘附能力��
保持憎水性表面的方法��
一種是把室內濕度保持在50%以下,并且在晶園完成前一步工藝之后盡可能快地對晶園進行涂膠。另一種是把晶園儲存在用干燥且干凈的氮氣凈化過的干燥器中��
此外,一個加熱的操作也可以使晶圓表面恢復到憎水性表靀��
有三種溫度范圍:150��-200��(低溫),此時晶圓表面會被蒸��(fā);到��400��(中溫)時,與晶圓表面結合較松的水分子會離開;當超過750��(高溫)時,晶圓表面從化學性質上將恢復到了憎水性條件。通常采用低溫烘烤,原因是操作簡單��
增粘處理��
增粘的作用是增強wafer與光刻膠之間的粘著力��
原因是絕大多��(shù)光刻膠所含的高分子聚合物是疏水的,而氧化物表面的羥基是親水的,兩者表面粘附性不好��
通常用的增粘劑:
HMDS(六甲基二硅胺��)。親水的帶羥基的硅烷��→疏水的硅氧烷結構,既易與晶圓表面結合,又易與光刻膠粘合��
方法有:
沉浸式,旋涂法和蒸汽��
2涂膠
涂膠工藝的目的就是在晶園表面建立薄的、均勻的、并且沒有缺陷的光刻膠膜。一般來說,光刻膠膜厚從0.5um��1.5um不等,而且它的均勻性必須達到只有正��0.01um的誤差��
光刻膠的涂覆常用方法是旋轉涂膠法��
靜態(tài)旋轉和動��(tài)噴灑
靜態(tài)涂膠��
首先把光刻膠通過管道堆積在晶圓的中心,然后低速旋轉使光刻膠鋪開,再高速旋轉甩掉多余的光刻膠,高速旋轉時光刻膠中的溶劑會揮發(fā)一部分��#p#分頁標題#e#

靜態(tài)涂膠時的堆積量非常關鍵,量少了會導致負膠不均勻,量大了會導致晶圓邊緣光刻膠的堆積甚至流到背面��
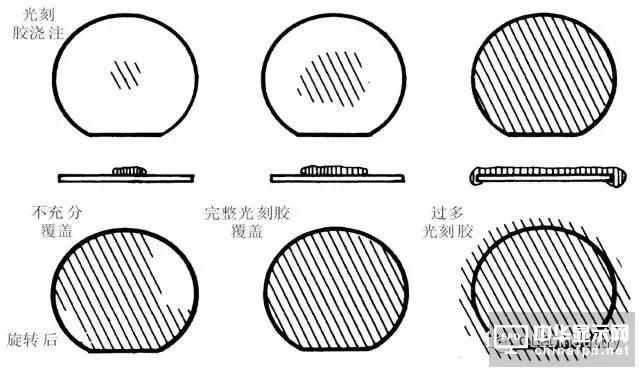
動態(tài)噴灑��
隨著wafer直徑越來越大,靜��(tài)涂膠已不能滿足要求,動態(tài)噴灑是以低速旋轉,目的是幫助光刻膠最初的擴散,用這種方法可以用較少量的光刻膠而達到更均勻的光刻膠膜,然后高速旋轉完成最終要求薄而均勻的光刻膠膜��

涂膠的質量要求是��
��1)膜厚符合設計的要求,同時膜厚要均勻,膠面上看不到干涉花紋;
��2)膠層內無點缺陷(如針孔等)��
��3)涂層表面無塵埃和碎屑等顆粒��
膜厚的大小可由下式決定:

式中,T為膜厚;P為光刻膠中固體的百分比含量;S為涂布機的轉速;K為常��(shù)��
3軟烘��
主要目的有:使膠膜內的溶劑揮��(fā),增加光刻膠與襯底間的粘附性、光吸收以及抗腐蝕能力;緩和涂膠過程中膠膜內產生的應力等��
4對準和曝��
對準是把所需圖形在晶圓表面上定位或對準,而曝光的目的是要是通過汞弧燈或其他輻射源將圖形轉移到光刻膠圖層上��
用盡可能短的時間使光刻膠充分感光,在顯影后獲得盡可能高的留膜率,近似垂直的光刻膠側壁和可控的線寬��
5PEB
在曝光時由于駐波效應的存在,光刻膠側壁會有不平整的現(xiàn)象,曝光后進行烘烤,可使感光與未感光邊界處的高分子化合物重新分布,最后達到平衡,基本可以消除駐波效應��

6顯影
顯影就是用顯影液溶解掉不需要的光刻膠,將掩膜版上的圖形轉移到光刻膠上��
7硬烘��
目的是通過溶液的蒸��(fā)來固化光刻膠,此處理提高了光刻膠對襯底的粘附性,為下一步工藝做好準備,如提高光刻膠的抗刻蝕能力��
8檢驗
顯影檢查是為了查找光刻膠中成形圖形的缺陷。繼��(xù)進行刻蝕工藝或離子注入工藝前必須進行檢查以鑒別并除去有缺陷的晶圓��
附:
技術資��
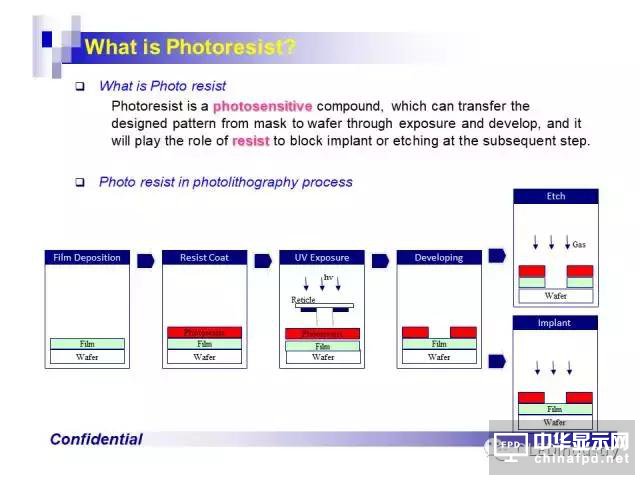


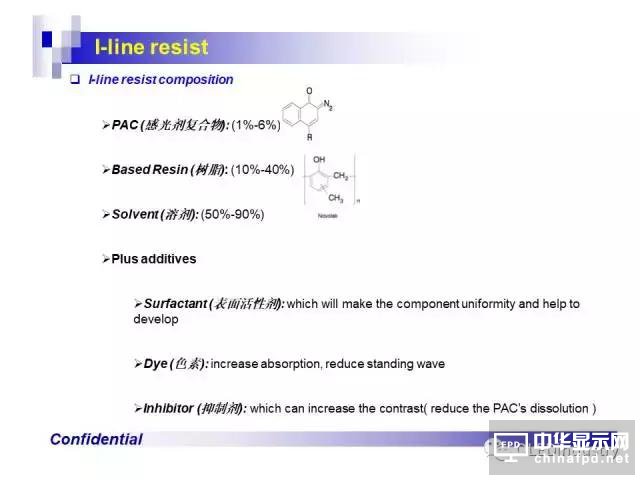






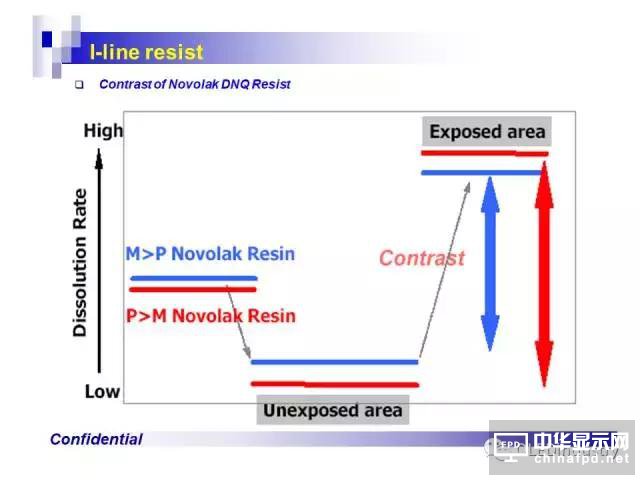
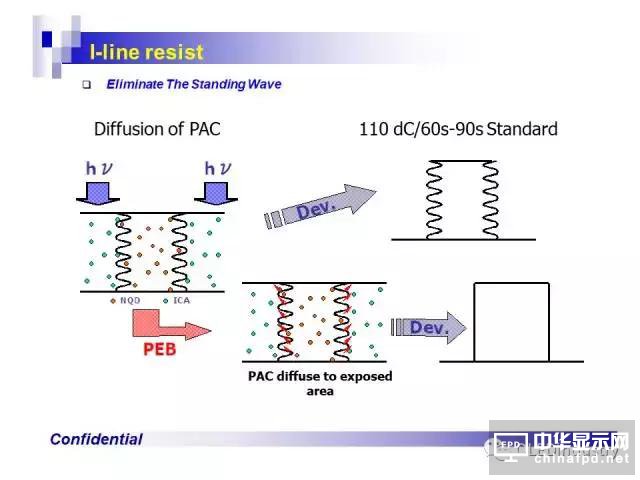
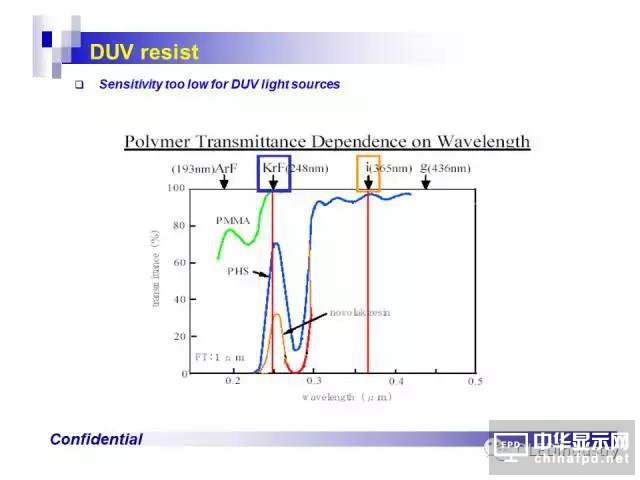




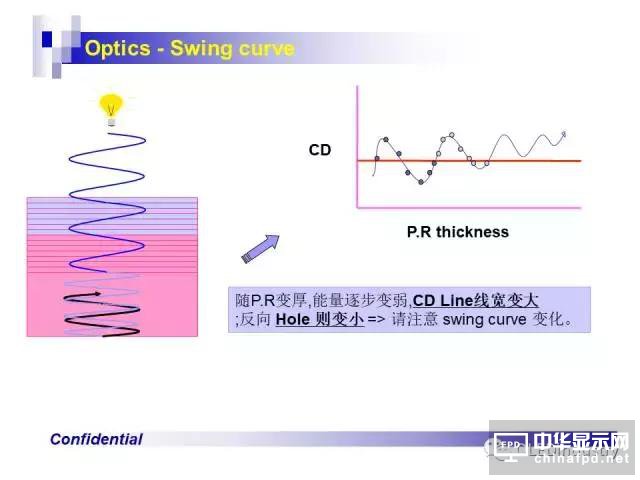



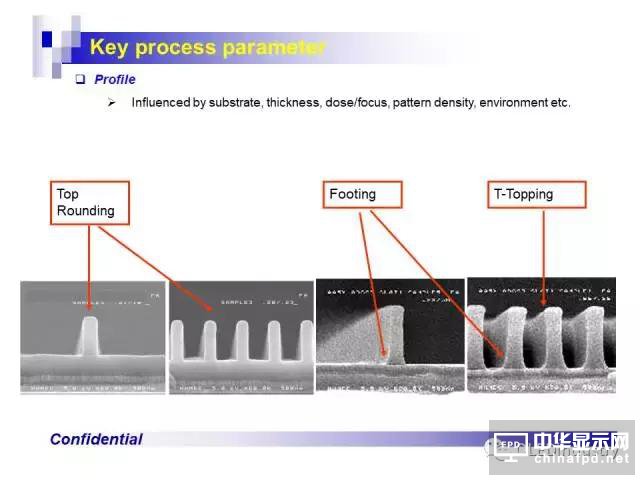
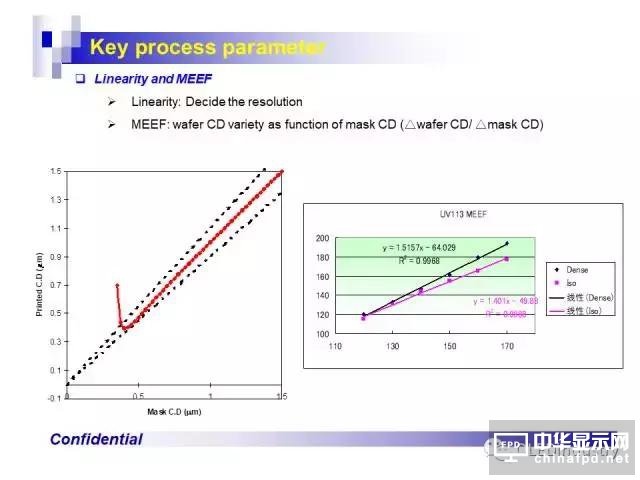
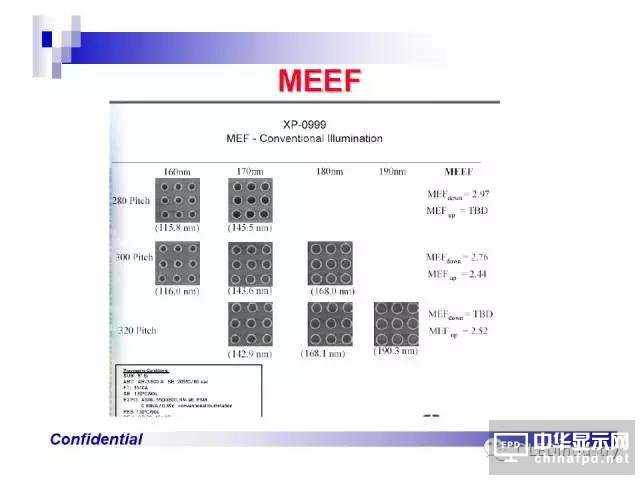
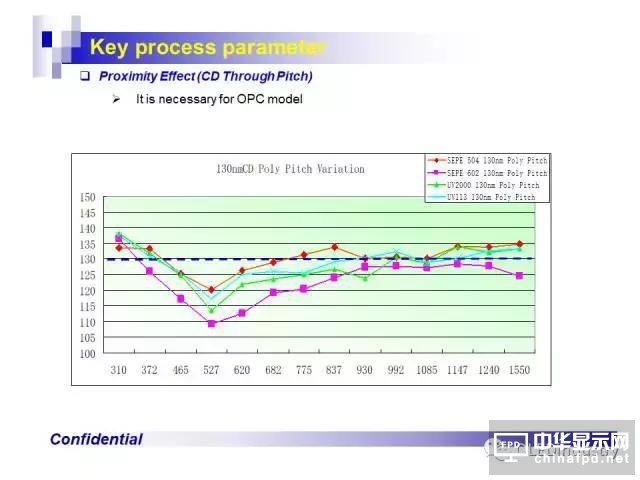
 #p#分頁標題#e#
#p#分頁標題#e#





關注我��

公眾號:china_tp
微信名稱:亞威資��
顯示行業(yè)頂級新媒��
掃一掃即可關注我��